Laser-Kühler si wesentlech fir d'Wafer-Dicing-Qualitéit an der Hallefleederproduktioun ze garantéieren. Indem se d'Temperatur kontrolléieren an den thermesche Stress miniméieren, hëllefen se Graten, Ofsplitterungen an Uewerflächenonregelméissegkeeten ze reduzéieren. Eng zouverlässeg Ofkillung verbessert d'Laserstabilitéit a verlängert d'Liewensdauer vun der Ausrüstung, wat zu enger méi héijer Chip-Ausbezuelung bäidréit.
Wat sinn déi üblech Problemer mat Wafer-Dicking a wéi kënne Laser-Kühler hëllefen?
Wafere sinn dat Grondmaterial an der Hallefleederproduktioun a déngen als Substrate fir integréiert Schaltungen an aner mikroelektronesch Geräter. Typesch aus monokristallinem Silizium hiergestallt, si Wafere glat, flaach a meeschtens 0,5 mm déck, mat üblechen Duerchmiesser vun 200 mm (8 Zoll) oder 300 mm (12 Zoll). De Produktiounsprozess ass héich komplex a besteet aus Siliziumreinigung, Barrenschneiden, Waferpoléieren, Photolithographie, Ätzen, Ionenimplantatioun, Elektroplatéieren, Wafertester a schliisslech Wafer-Dëschschneiden. Wéinst hire Materialeegeschafte verlaangen d'Wafere eng strikt Kontroll iwwer Rengheet, Flaachheet a Defektraten, well dës direkt d'Leeschtung vum Chip beaflossen.
Gemeinsam Erausfuerderunge beim Wafer-Schneiden
Laser-Dicing-Technologie gëtt wäit verbreet an der Waferveraarbechtung benotzt wéinst hirer héijer Präzisioun a kontaktlose Virdeeler. Wéinst hirer héijer Präzisioun a kontaktlose Virdeeler kënnen awer verschidde Qualitéitsproblemer beim Dicing optrieden:
Graten a Splitter: Dës Defekter entstinn dacks duerch inadequater Ofkillung oder ofgenotzt Schneidinstrumenter. D'Verbesserung vum Ofkillsystem andeems d'Kältekapazitéit verbessert gëtt an de Waasserfloss erhéicht gëtt, kann hëllefen, d'ongläichméisseg Heizung ze reduzéieren an d'Kanteschied ze minimiséieren.
Reduzéiert Schnëttgenauegkeet: Verursaacht duerch schlecht Maschinnpositionéierung, onstabil Aarbechtsdëscher oder falsch Schnëttparameteren. D'Genauegkeet kann duerch Verbesserung vun der Maschinnkalibratioun an Optimiséierung vun de Parameterastellungen erëm hiergestallt ginn.
Ongläich Schnëttflächen: Verschleiss vun der Klingen, falsch Astellungen oder falsch Ausriichtung vun der Spindel kënnen zu Ongläichheeten vun der Uewerfläch féieren. Reegelméisseg Ënnerhalt a Rekalibrierung vun der Maschinn si wesentlech fir e reibungslosen Schnëtt ze garantéieren.
Roll vu Laserkillmaschinnen beim Wafer-Würfelschneiden
Laser-Kühler spille eng wichteg Roll fir d'Leeschtung a Stabilitéit vu Laser- an optesche Systemer, déi beim Wafer-Dëschschneiden agesat ginn, z'erhalen. Duerch eng präzis Temperaturkontroll verhënneren si d'Laserwellenlängtendrift, déi duerch Temperaturschwankungen verursaacht gëtt, wat entscheedend ass fir d'Schnëttgenauegkeet z'erhalen. Eng effektiv Ofkillung miniméiert och den thermesche Stress beim Schnëttschneiden, wouduerch de Risiko vu Gitterverzerrung, Ofsplitteren oder Mikrorëss reduzéiert gëtt, déi d'Waferqualitéit a Gefor brénge kënnen.
Zousätzlech benotzen Laser-Kühler e zougemaacht Waasserkillungssystem, dat de Killkreeslaf virun externer Kontaminatioun isoléiert. Mat integréierten Iwwerwaachungs- an Alarmsystemer verbesseren si d'laangfristeg Zouverlässegkeet vun der Wafer-Dicing-Ausrüstung däitlech.
Well d'Qualitéit vum Wafer-Dicking direkt en Afloss op d'Chip-Ausbezuelung huet, hëlleft d'Integratioun vun engem zouverléissege Laser-Kühler, heefeg Defekter ze minimiséieren an eng konsequent Leeschtung ze garantéieren. D'Auswiel vum passenden Killer op Basis vun der thermescher Belaaschtung vum Lasersystem an dem Betribsëmfeld, zesumme mat reegelméisseger Ënnerhalt, ass de Schlëssel fir e stabile an effiziente Betrib ze garantéieren.
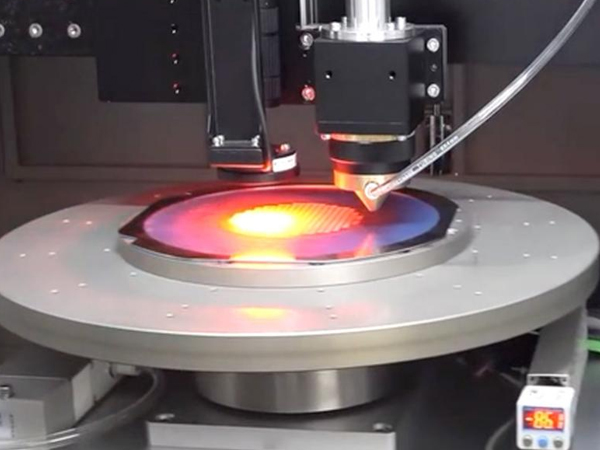

Mir sinn fir Iech do, wann Dir eis braucht.
Fëllt w.e.g. de Formulaire aus fir eis ze kontaktéieren, a mir hëllefen Iech gären weider.









































































































